
Interview
Vol.230
반도체 패키징,
내일을 위한 도약
창의원천연구본부 저탄소집적기술창의연구실 최광성 실장
ETRI가 반도체 패키징 기술 역사에 한 획을 그었다.
상온에서 접합이 가능하고, 기존 대비 전력 95%를 절감할 수 있으며, 유해 물질도 나오지 않는다.
이토록 완벽한 반도체 패키징 기술 개발이 가능할 수 있었던 이유는 무엇일까?
바로 오랜 시간 끝에 개발된 신소재, Laser NCF 덕분이다.

반도체 패키징이란 무엇인가요?
반도체 패키징은 후공정이라고도 알려져 있는데요. 반도체를 손실 없이, 어떤 환경에서도 안정적으로 외부에 전달하는 것을 목표로 하고 있습니다. 기존에는 전공정에서 완성된 웨이퍼를 낱개 칩으로 하나하나 분리하여 플라스틱 기판에 접합한 다음, 전기적으로 연결한 후, 몰딩 공정으로 안전하게 보호하는 방식으로 공정이 이루어졌습니다.
최근에는 플라스틱 기판이 아닌 실리콘 웨이퍼에서 패키징 공정이 이루어지고 있습니다. 이에 따라 새로운 기술이 많이 개발되고 있어요. 첨단 반도체 패키징 기술을 적기에 확보하지 못하면 반도체 전쟁에서 패할 수밖에 없는 상황이에요. 그래서 최근 주요 반도체 업체, 패키징 파운드리, 그리고 정부가 패키징 관련 기술 개발을 활발하게 진행하고 있어요.

면 레이저를 통한 칩렛 칩적 공정 수행 모습
반도체 칩렛 패키징 기술은 기존 패키징 기술의 한계를 뛰어넘은 것 같습니다.
앞서 말씀드렸듯이 첨단 반도체 패키징 기술이 반도체 전쟁에서 승부를 가르는 핵심입니다. 바로 ‘칩렛(Chiplet)’이 그러한 영역입니다. 칩렛은 우리말로 ‘조각 칩’으로 해석할 수 있습니다. 첨단 반도체 개발 비용은 너무 많이 들어요. 그렇다고 해서 기존처럼 하나의 칩에 모든 기능을 넣는다면, 수율이 떨어지게 됩니다. 다시 말해 불량률이 높아 사업성이 낮아지게 되는 것이죠.
칩렛은 다소 낮은 반도체 노드에서 서로 다른 기능을 가진 작은 칩들을 제조함으로써 수율을 높이자는 개념입니다. 하지만 장단점이 있습니다. 반도체 개발 및 양산 비용은 절감할 수 있지만, 칩렛을 기판에 집적하는 것이 어려워집니다. 이는 서로 다른 기능을 가진 작은 칩들이 서로 소통하려면 밀도가 매우 높은 연결통로가 필요하기 때문인데요. 이러한 통로는 기존의 플라스틱 기판에서는 구현할 수 없습니다. 하지만 칩렛 패키징에서는 실리콘 웨이퍼를 기판으로 사용하면서 이번에 개발한 패키징 기술을 더해 구현할 수 있게 됐습니다.
실리콘 웨이퍼에 저희가 개발한 필름을 붙이고, 칩렛들을 배열한 타일에 레이저를 1초 정도 조사한 후 경화하면 공정이 완료되는데요. 기존 9단계 이상의 복잡한 공정을 3단계 기술로 간략화했습니다. 또한 밀도가 매우 높은 연결통로를 단 1초 만에 연결할 수 있다는 점에서 차별화가 있습니다. 이것이 가능하게 된 이유는 20여 년의 연구 끝에 개발한 Laser NCF(Non-Conductive Film)라는 소재 덕분입니다.
Laser NCF은 어떤 특징이 있나요?
Laser NCF는 레이저를 조사하였을 때, 조각 칩의 솔더범프(Solder Bump)라는 연결통로를 실리콘 웨이퍼 위에 있는 금속 패드에 연결시켜준다는 특성이 있습니다. 일반적으로 솔더범프는 산화가 잘 되는데, Laser NCF는 1초도 안 되는 시간에 솔더범프의 산화막을 제거하여 솔더범프와 금속 패드를 연결합니다. 동시에 기계적으로 약한 솔더범프를 잡아줘서 높은 신뢰성을 갖도록 돕습니다.
Laser NCF 제조에 사용하는 소재는 모두 국산입니다. 처음 Laser NCF를 개발할 때 핵심이 되는 원소재는 주로 일본에서 수입했습니다. 그러나 Laser NCF를 국산화하지 않으면 위험할 수도 있겠다는 생각이 들었어요. 그래서 국산화에 착수했고, 원재료 국산화를 이뤘습니다.

ETRI가 개발한 칩렛 패키징 공정용 신소재
신소재 개발 과정이 쉽지만은 않았을 것 같습니다.
Laser NCF의 개념은 20여 년 전, 소재 개발을 전담하시는 엄용성 박사님의 아이디어에서 출발했습니다. ‘짧은 시간 안에 금속패드와 솔더범프의 접합을 가능하게 하자’가 출발이었습니다. 접합을 위해서는 3~5분의 시간이 필요했는데 이 시간을 1~3초로 줄이는 것을 목표로 했죠.
처음에는 아이디어를 구현하기가 어려웠고, 막상 아이디어를 구현하자 응용 분야를 찾기가 어려웠습니다. 그러던 중 2015년에 레이저라는 새로운 공정을 알게 됐어요. 레이저에 개발 소재를 적용함으로 사장될 뻔했던 기술이 살아나게 됐습니다.
개발된 첨단 칩렛 패키징 기술은 질소가스가 필요 없다고 들었습니다.
기존 공정에는 질소가스가 필요했어요. 산소가 솔더범프를 산화시키기 때문이었죠. 게다가 공정을 하게 되면 환경이 고온으로 유지돼요. 솔더범프가 더욱 산화되기 좋은 환경인 거죠. 이를 원천 봉쇄하기 위해 반응성 없는 질소가스를 사용했어요.
이번에 개발한 기술은 공정 시간이 1초입니다. 공정 시간이 짧기 때문에 질소가스가 필요 없어지게 됐죠. 더불어 Laser NCF가 솔더범프 전체를 감싸고 있는 구조 덕분에 산소와 만날 일이 없어졌어요. 따라서 질소가스 없이 공정이 가능하게 됐습니다.
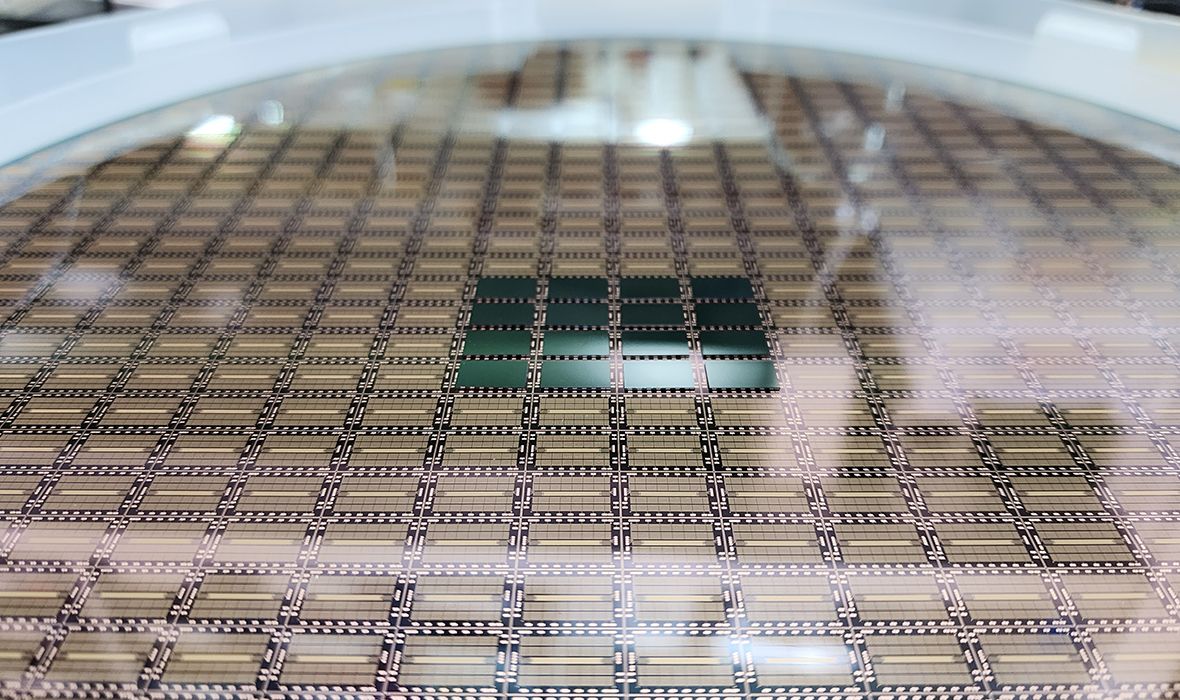
칩렛 패키징 공정을 적용하여 300mm 웨이퍼에 집적된 칩렛
칩렛 패키징 기술은 상온에서 직접 공정할 수 있습니다.
그 원리가 궁금합니다.
ETRI가 가진 나노 기술을 적용한 것으로 특정 온도가 되면 활성화되는 원소재들을 잘 설계했기 때문입니다.
일정온도가 되면, 원소재 중 일부는 활성화가 돼요. 그때 원소재와 다른 소재의 반응이 무척 특이해요. 기존에는 약 100℃ 정도에서 상태를 유지하다가, 온도가 올라가면 활성화되는 기법을 사용했어요. 이번에 ETRI가 개발한 기술은 상온에서도 갑자기 온도를 올리면 활성화될 수 있도록 했어요. 이를 위해 원소재들을 선택하고 그 조합을 설계했습니다.
상온 스테이지에서 접합하는 기술은 첨단 반도체 패키징뿐만 아니라, 마이크로 LED 디스플레이 등에서 항상 요구해 왔던 기술입니다. 스테이지 온도가 높으면 스테이지 위에 있는 기판이나 웨이퍼가 팽창하게 되고, 이로 인한 접합 정밀도가 떨어지기 때문이죠.
접합 정밀도를 유지하는 원천기술은 모두 해외 장비 업체만이 보유하고 있었습니다. 이번 상온 공정 기술 개발을 통해 우리나라 장비 업체도 그동안 엄두 내지 못했던 고정밀의 접합 장비를 개발할 수 있는 원천기술을 보유할 수 있게 되었다는 면에서 의미가 있습니다. 또한, 상온 스테이지임으로 전력 소모를 획기적으로 절감할 수 있습니다.
칩렛 패키징 기술은 어떤 분야에 사용될 것이라고 보시나요?
칩렛 패키징 기술은 챗GPT로 유명해진 NVIDIA의 차세대 GPU(Graphics Processing Unit)* 모듈과 같은 인공지능 모듈과 삼성전자와 애플의 차세대 애플리케이션 프로세서 등에 적용되는 기술입니다. 즉, 인공지능 모듈과 스마트폰 및 패드용 시스템 반도체에 ETRI가 개발한 기술이 적용될 수 있습니다.
실제로 이 분야와 연관된 세계적인 종합 반도체 기업 한 곳과 함께 개발한 기술의 공정성과 신뢰성을 평가하고 있어요. 평가에서 주어진 조건을 만족한다면 상용화까지 3년 정도의 시간이 걸릴 것이라고 봅니다. 또한 마이크로 LED를 이용하는 디스플레이에 적용될 것으로 예상합니다. 이를 위해 미국 실리콘 밸리의 스타트업과 공동 연구를 진행하고 있습니다.
* GPU(Graphics Processing Unit): 그래픽카드의 핵심 칩.

실장님과 연구소의 추후 연구 계획과 포부를 듣고 싶습니다.
대한민국은 반도체와 디스플레이 분야의 산업화를 성공적으로 이루어 냈어요. 주로 해외에서 개발된 소재와 장비를 들여와 값싸게 만드는 방법을 사용했죠. 그러나 이제 대한민국은 새로운 기술로 산업화를 이루어야 합니다. 기존의 기술로는 해결하기 어려운 부분들이 생기고 있거든요. 기존 공법으로는 기후 위기를 해결할 방법이 없고, 칩렛 시장을 만들어 나갈 기술도 부족한 상황이에요. 저탄소집적기술창의연구실은 이 문제들의 답을 제시하고, 산업화를 이루는 데 앞장서고 싶어요. ETRI가 개발한 기술이 세계의 산업적 표준이 되는 첫 사례를 만들어 나가고 싶습니다.