VOL. 177 June 2021
반도체의 미래를
책임질 소재 연구
우리 일상 속에서 흔히 듣는 단어 중 하나가 바로 반도체다.
우리나라의 대표적인 산업이자 스마트폰, TV, 컴퓨터, 자동차 등
우리 생활 곳곳의 전자기기에서 핵심적인 역할을 하는 것이 바로 반도체다.
수도 없이 많이 들어보았을 이름이지만, 반도체가 정확하게 어떻게 만들어지고 어떤 역할을 하는지 아는 사람은 많지 않다.

반도체를 아시나요?Semiconductor
반도체란 전기가 통하는 물체를 말하는 도체와 전기가 통하지 않는 물체인 부도체의 중간 성질을 가지고 있는 물체를 말한다. 즉 일반적인 상황에서는 전기가 통하지 않지만, 불순물이 첨가되거나 빛을 비출 때, 열을 가할 때 등 외부의 자극이 있는 경우 전기가 통하는 물질을 가리켜 반도체라고 말한다. 이렇게 전기 신호를 목적에 따라 제어할 수 있도록 만드는 것이 바로 반도체다. 대표적인 반도체 물질로는 실리콘과 게르마늄이 있는데, 규소라고도 불리는 실리콘은 지구에서 산소 다음으로 풍부하고 구하기 쉬워 반도체의 재료로 널리 사용된다.
반도체를 만들기 위해서는 반도체 회로를 만드는데 사용되는 주재료인 웨이퍼1)를 만드는 웨이퍼 제조 공정을 시작으로 웨이퍼에 절연막 역할을 하는 산화막을 형성해 회로와 회로 사이에 전류가 누설되는 것을 막는 산화 공정, 반도체에 회로를 그려 넣는 포토 공정, 반도체 회로에 전기 신호가 잘 전달되도록 전기길(금속선)을 연결하는 금속배선공정, 반도체 개별 칩들의 품질을 확인하는 EDS(Electrical Die Sorting) 공정, 마지막으로 반도체 칩이 외부와 신호를 주고받을 수 있도록 길을 만들고 외부 환경으로부터 보호받는 형태로 만드는 패키징 공정 등이 필요하다.
1) 웨이퍼
반도체 회로의 기본이자 핵심재료.
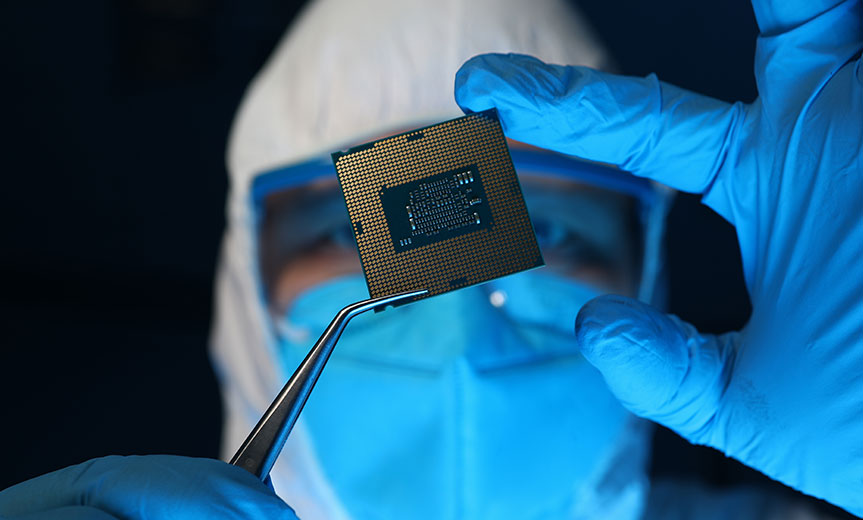
반도체를 기기와 연결하다,
솔더 범프(Solder Bump)Solder Bump
웨이퍼 제조 공정에서 EDS 공정까지 마치게 되면 웨이퍼를 절단하는 과정 등을 지나 기기와 반도체를 연결하는 본딩(Bonding, 접착) 공정이 필요하다. 전통적으로는 반도체 소자와 기기의 기판을 가는 금속 선으로 연결하는 와이어 본딩(Wire-Bonding) 공정 방식이 이뤄졌다. 최근에는 와이어 본딩 방식보다 전기 저항은 더 작고 속도는 더 빠르게 만들기 위해 반도체 칩 회로와 기판을 공 형태로 직접 연결하는 (Flip chip) 패키징 방식이 많이 사용된다.
이때 주로 금이나 솔더(Solder, 주석/납/은의 화합물)로 돌기가 만들어지는데, 솔더가 사용된 돌기를 ‘솔더 범프’라고 부른다. 일반적인 기기에는 150μm보다 넓은 크기의 솔더 범프가 사용된다. 최근에는 AR(Argumented Reality, 증강현실)과 VR(Virtual Reality, 가상현실) 구현 등 더 복잡한 반도체 회로가 필요한 기기와 영역이 생겨나면서 직경 1~10μm의 솔더 범프를 만들어내는 데까지 도달했다. 솔더 범프 기술은 1960년대 미국의 IBM사에서 C4(Contrilled Collapse Chip Connection)으로 알려진 솔더 범프 기술을 개발한 것을 시작으로 지금까지 계속해서 발전되고 있다. 프랑스의 시장조사기관인 Yole은 직경 400~500μm(마이크로미터)의 솔더 범프를 BGA(Ball Grid Array), 직경 250~400μm의 솔더 범프를 CSP(Chip Scale Package), 직경 10~100μm의 솔더 범프를 “마이크로 범프”라고 정의했다.
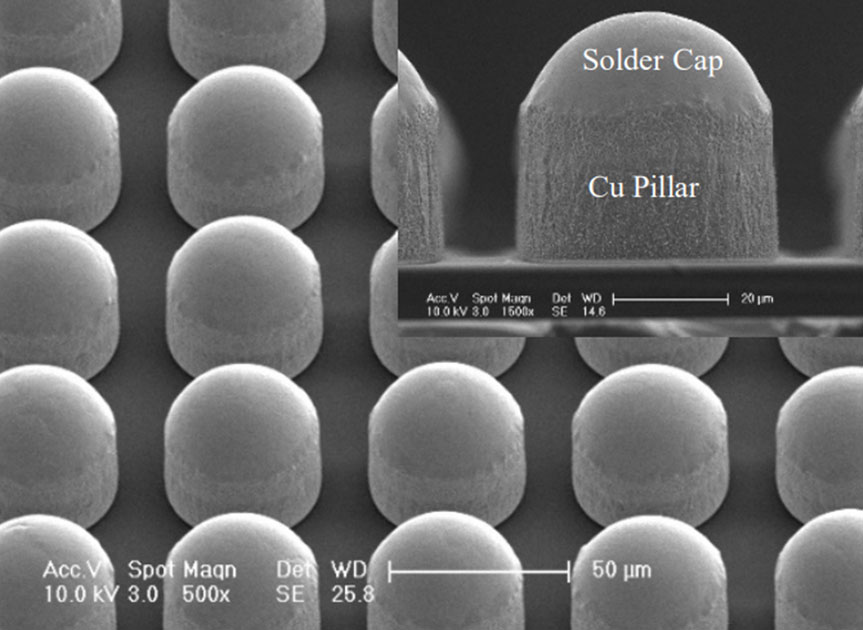
반도체와 기기를 더욱 단단하게,
언더필(Underfill) 소재Underfill
다양한 크기와 형태의 솔더 범프를 기판에 접합하기 위해서는 리플로우 공정이 사용된다. 리플로우 공정은 솔더 범프에 형성된 산화막을 제거하기 위해서 반도체 소자와 기판 사이에 송진을 기반으로 만든 플럭스(Flux, 산화막의 환원을 촉진하기 위한 물질)를 도포한 후에 반도체와 기판을 정렬하고 가열하는 공정이다. 리플로우 공정 뒤에 반도체와 기판 사이에 플럭스가 남아있게 되면 부식되거나 오염되는 등의 문제가 발생하기 때문에 남아있는 플럭스를 제거하는 세척 공정도 필요하다. 이렇게 플럭스를 제거하고 나면 반도체 소자와 기판 사이 솔더 범프의 기계적 안정성을 위해 반도체와 기판 사이에 전기가 통하지 않는 절연체를 채워넣는다. 이 절연체를 ‘언더필’이라고 부르는데, 이 언더필은 모세관 현상을 통해 반도체와 기판 사이를 채운다. 식물의 뿌리에 있는 물이 줄기에서의 모세관 현상으로 잎까지 공급되는 것과 같은 원리다.

새로운 소재가 더 정밀한
반도체 회로를 가능하게 하다New material
그런데 반도체 소자와 기판 사이의 간격이 좁아질수록, 즉 솔더 범프의 크기가 작아질수록 세척 공정이 어려워지며 언더필 공정에서 공극(Void, 공기로 채워진 틈)이 발생하게 된다. 특히, 반도체 소자와 기판 사이의 간격이 20μm 이하가 되는 경우에는 세척 공정 및 언더필 공정이 불가능하게 된다. 따라서 2010년도 이후에는 플립칩 공정과 언더필 공정을 동시에 만족하고, 기존 플립칩 공정을 위한 소재가 포함하지 않고 있던 플럭싱 기능까지 가지고 있는 소재와 공정의 개발이 필요했다. 이에 이 조건들을 만족시키는 ‘에폭시 기반 접합 소재’가 주목받고 있다.
첫 번째로 플럭싱 언더필 소재를 플럭스 대신 기판에 도포하고 리플로우 공정을 하면 세척 및 언더필 공정이 필요없게 된다. 플럭싱 언더필 소재는 산화막을 제거하는 플럭스 기능을 고분자로 구현할 뿐만 아니라 모든 성분이 고분자로 되어 있어 세척이 필요 없다. 또한, 리플러우 공정 이후에도 솔더의 기계적 신뢰성을 높여 언더필 역할을 한다.
두 번째로 하이브리드 언더필 소재는 플럭싱 언더필 소재에 솔더 분말을 섞은 것이다. 하이브리드 언더필 소재는 솔더 범프가 형성되지 않은 상태의 반도체와 기판 간 전극을 연결하기 위한 소재다. 하이브리드 언더필 소재를 공정에 적용하면 먼저 기판의 금속 패드 위에 하이브리드 언더필 소재를 도포한 후 솔더 범프가 형성되지 않은 상태의 반도체 소자를 정렬한다. 여기에 리플로우 공정을 적용하면 솔더 분말이 녹는 것과 함께 하이브리드 언더필 소재의 레진에 의해 산화막이 제거된다. 그 뒤로 솔더 분말은 솔더 범프를 형성하고 동시에 기기와 반도체 사이가 솔더 범프로 연결된다. 플럭싱 언더필에서와 마찬가지로 솔더 범프는 레진에 의해 신뢰성이 증가된다.
이번 글에서는 반도체 패키징 과정과 소재로서 주목받고 있는 소재를 소개했다. 앞으로도 차세대 대형 디스플레이, AR, VR 등 다양한 분야에서 반도체의 활약이 더욱 두드러질 것으로 예상되는 가운데 차세대 반도체 소재 관련 연구를 관심 있게 지켜보도록 하자!

본 내용은 전자통신동향분석 35권 4호(통권 184)를 참고,
‘반도체 패키징용 에폭시 기반 접합 소재 및 공정 기술 동향’을 재구성한 글입니다.
